リソグラフィ技術開発
最先端の半導体製品開発を、コンピューテショナル・リソグラフィ技術で支えています。
半導体微細化の進展でパターン寸法が露光波長より小さくなったことで、設計パターンをそのままマスクへ転写しても、設計通りのパターンをウェハー上に形成することが出来なくなっています。最先端の微細加工には、OPC(Optical Proximity Correction:光近接効果補正)等の超解像技術を、大規模コンピューター環境において、いかに具現化するかが競争力の源泉であり差異化技術となっており、あらゆるニーズに対応したフォトマスクデータ生成のソリューションを提供しています。
- 最先端の微細加工を実現するマスクデータを提供
- 最先端のコンピュータ技術を駆使した高速処理
- 世界最高レベルのTATと高品質化を追求
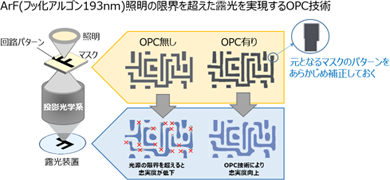
業務内容
-
マスクデータ作成用システム開発
半導体製品のウェハー作製は、昔ながらの写真のように、微細な電子回路をガラス基板上に描画した「フォトマスク」を使ってウェハーへ焼き付けます。このフォトマスクを作成するためのデータを生成する、MDPと呼ばれる処理に必要なシステム開発を行っています。
-
OPCシステム開発
近年の微細化により、設計した通りにウエハー上に転写出来ない誤差成分(OPE)を、コンピューターを使って予測(シミュレーション)し、それを打ち消すようにマスクパターンを補正(OPC)することで所望のパターンをウェハー上に形成するOPCシステムの開発を行っています。さらに微細化が進むことによって増加するウェハー上での不良箇所をシミュレーションによって予測し、設計パターンを自動修正する技術を開発して、高品質な先端プロセスのマスクデータを提供することを可能にしています。
-
大規模計算システムの利用技術開発
メモリ製品の大規模化、マスクパターン複雑度の高まりからOPCに必要なシミュレーションなどの計算量は増え続けており、大量のCPUを効率的に機能させる利用技術開発を行っています。
